Overview
サービスの概要
当社では、携帯電話の発売当初から培ってきた信頼性の高いはんだ付け技術を活かし、リワークサービスを幅広く展開しています。
高性能のリワーク装置を用い、温度を管理しながらのBGA/CSP/QFN(集積回路の一種)などのさまざまなパッケージ製品のリワーク作業をはじめ、POP実装やアンダーフィル付のBGAリワーク作業、プレスフィットコネクタなどの特殊部品の交換作業など、あらゆる集積回路基板のお困りごとや部品交換後の各種評価試験までトータルにご提供。お客様の製品品質向上、コスト削減に貢献しています。
*基板から部品を取り外して、新しい部品に交換する作業

Features
サービスの特長
実績が豊富
交換が不可能と考えられていた部品でも作業を可能にした実績があります。周辺部品に与える熱ダメージを最小限に保ちつつ、指定の温度プロファイルにてBGA交換・CSP交換作業を実施することが可能です。(BGAはんだボール部へのジャンパー線取付もご相談に応じます。)
短納期
BGA/CSPの再利用・基板改造等のお手伝いが短納期で可能です。
徹底した温度プロファイル管理のもとに、デバイスに対する熱影響を最小限にとどめ、Ø0.3~0.76のリボールが可能です。(1個からでもご相談に応じます。)
| リワークサービス | ・BGA/CSP取り外し・取り付け作業 ・BGA/CSPのアンダーフィル塗布品に対する取り外し・取り付け作業(エポキシ系対応可) ・BGA/CSPリボール作業(はんだボール再搭載) ・POP実装部品リワーク、LGA実装部品リワーク、QFN実装部品リワーク ・その他部品交換、基板改造 (SOP、QFP、SIP等の部品交換、及びジャンパー改造、0402サイズチップ等の部品交換、その他) |
| その他付加サービス | ・BGA/CSP等の部品取り付け後のアンダーフィル等対応 ・評価試験 (1)環境試験(温度、湿度、ヒートサイクルを実施し、外部環境への対応性を確認) (2)加圧試験(基板に物理的荷重を加え、応力への耐久性を確認) (3)衝撃試験(製品を落下させ、衝撃に対する耐久性を確認) |
| 納期 | BGA/CSPのボールサイズがØ1.00mm未満、または昼迄にパッケージの寸法図面と対象基板、 および交換部品をご送付いただけましたら、翌日の昼迄に発送準備することが可能です。 |
Service Case
サービス事例のご紹介
BGA/CSP交換作業(実施例1)
アンダーフィル塗布BGA/CSP交換作業
(1)専用治具製作
交換部位の周辺を確認し、熱による影響を考慮した専用治具を製作します(周辺温度差60℃以上の実績あり)。
(2)温度プロファイル採取
ICに熱電対を取付け、IC取付用、IC取外用温度プロファイルを採取します。
(3)部品の取外し
熱風等の加熱によりICを取外します。場合によっては加熱以外の特殊作業で取外す場合もあります。
(4)整地
ICを取外した後に残ったはんだとアンダーフィルを除去します。
(5)部品の取付け
はんだボール部にフラックスを印刷し、取付け用温度プロファイルにてICを加熱し取付けます。
(6)最終確認、アンダーフィル注入
取り付け状態を目視確認後、電気的な動作確認を行います。
問題なければ、必要に応じアンダーフィルを注入し、ICを固定します。

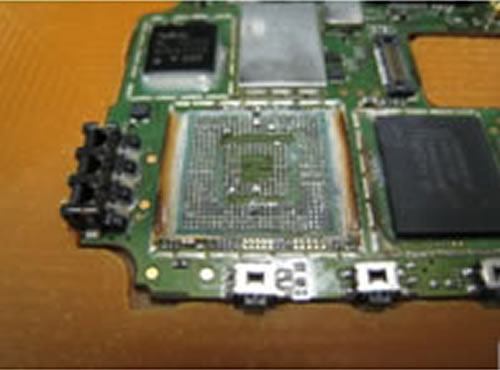
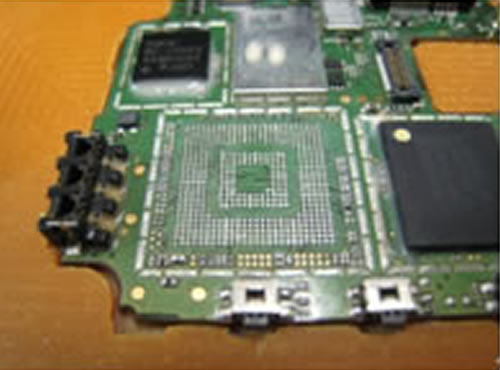

BGA/CSP交換作業(実施例2)
BGA/CSP交換・リボール作業
(1)交換温度プロファイル採取
ICに熱電対を取付け、IC取付用、IC取外用温度プロファイルを採取します。
(2)部品の取外し
熱風によりICを取外します。場合によっては熱風以外の特殊作業で取外す場合もあります。
(3)ボール搭載用温度プロファイル採取
ICのパターンに残っているはんだを清掃し熱電対を取付け、温度プロファイルを採取します。
(4)フラックス印刷、ボールの搭載
ICパターン上にフラックスを印刷し、はんだボールを搭載します。
(5)はんだボール溶融
はんだボール搭載後、温度プロファイル通りICを加熱し、はんだボールをパターンになじませます。
(6)クリームはんだ印刷
ICのボール部にフラックスを印刷します。
・はんだボールが0.5mmφ以上・・・・クリームはんだを印刷
(7)部品の取付
リワーク装置で温度プロファイルの通りICを取り付けます。完了後、はんだボールのなじみ具合を目視確認します。
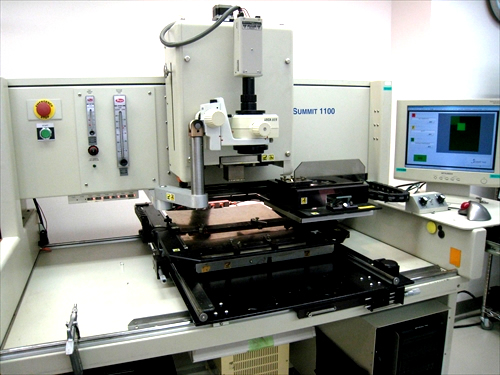
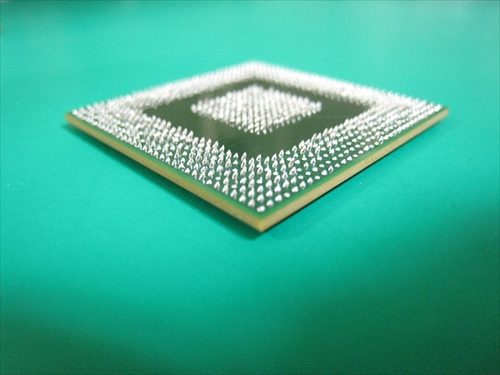
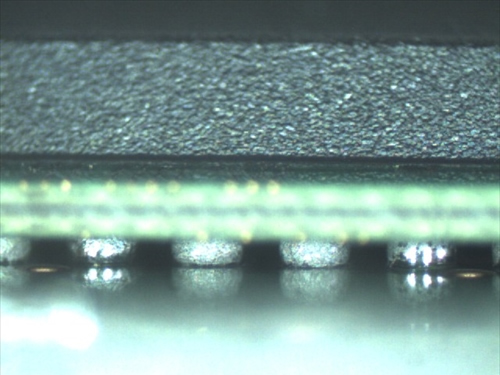
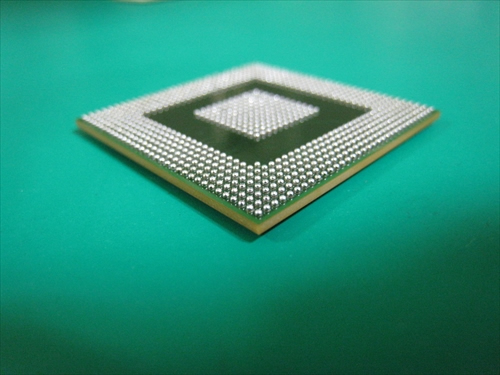
マニュアルソルダリング
手はんだ付け・手付け実装
基板リワークについては、携帯電話の修理再生サービスで培ってきた豊富な経験と実績を基に、昨今では試作実装・改造・小ロット製造など幅広く業務展開を行っています。
特に微細部品のはんだ業務を得意分野としており、表面実装では0402サイズからのチップ部品、0.4mmピッチからのSOP・QFP、コネクタ等の部品交換、鉛フリー製品への配慮など、お客様のご希望通りの作業を行うことが可能です。
また、公的資格マイクロソルダリング インストラクター資格を持つ指導者が、作業者に対して、技術指導・指示を行っています。
改造例1
チップ2段ソルダリング
+ジャンパー接続
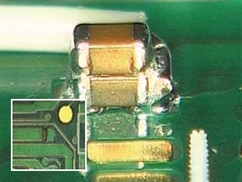
0402サイズチップ上に0402サイズチップをはんだ付けし、ジャンパー線(芯線0.2mm)をはんだ付けした改造。
・ご要望により3段、4段のはんだ付けや2列、3列のはんだ付けにも対応します。
・パターンカット(幅0.1mm~)
改造例2
ジャンパー接続

・熱対策のボンディングも対応可能。リフローも安心です。
改造例3
チップ部品へ接続

0.4mmファインピッチコネクタから各チップヘ、ジャンパー線の取付が可能。
・狭い場所でもジャンパー線の取付が可能。
・シールド板金の加工、交換もできます。
改造例4
コネクタパターンから
ジャンパー接続

0.4mmファインピッチコネクタパターン80Pinからジャンパー線(芯線0.2mm)をはんだ付けした改造。
ご相談・お見積り無料です。お気軽にお問い合わせください。
WEBからのお問い合わせ
Related Solution















